Views: 1 创始人: Site Editor Publish Time: 2025-04-16 Origin: Site








As a back-end process in semiconductor
manufacturing, the packaging process includes back grinding, dicing, die
bonding, wire bonding, and molding. The sequence of these processes can be
adjusted, combined with each other, or combined according to changes in
packaging technology. In the previous issue, we introduced the dicing process
of cutting wafers into individual chips. Today, we're going to talk about die
bonding, which is a packaging process in which chips cut from wafers are bonded
to a package substrate (leadframe or printed circuit board) after the dicing
process.
<!--[if !supportLists]-->1.<!--[endif]-->What is
Bonding? / Figure 1. Bonding type
In the semiconductor process,
"bonding" means fixing a wafer chip to a substrate. The bonding
process can be divided into two categories: traditional methods and advanced
methods. The traditional method uses Die Bonding (or Die Attach) and Wire
Bonding, while the advanced method uses Flip Chip Bonding, which IBM developed
in the late 60s. Flip chip bonding technology combines die bonding with wire
bonding to connect the chip to the substrate by forming bumps on the die pads.
Just as an engine powers a car, chip
bonding technology connects a chip to the outside world by attaching a
semiconductor chip to a lead frame or printed circuit board (PCB). Once the die
is bonded, make sure that the die can withstand the physical stress that occurs
after packaging and is able to dissipate the heat generated during the
operation of the die. If necessary, constant electrical conductivity must be
maintained or a high level of insulation must be achieved. As a result, as chip
sizes continue to shrink, bonding technology becomes more and more important.
<!--[if !supportLists]-->1、
<!--[endif]-->Die Bonding Steps: Comparison
between Die Bonding and Flip Chip Bonding
In the die bonding process, an adhesive is
first applied to the package substrate and then the chip is placed on the
substrate with the top side facing up. In contrast, flip chip bonding is a more
advanced technique in which a small bump called a "solder ball" is
attached to the die pad and the die is placed on the substrate with the top
side down of the chip. In both methods, the assembled unit goes through a
channel called Temperature Reflow, which adjusts the temperature over time to
melt the adhesive or solder balls. Then, after cooling, the chip (or bump) is
fixed to the substrate.
1. Chip Pick & Place
The process of removing hundreds of chips
attached to the cutting tape one by one is known as "picking". The
process of using a plunger to pick up a good chip from a wafer and place it on
the surface of a package substrate is known as "placement". Together,
these two tasks are called "pick and place" and are performed on Die
Bonder 1. After die bonding to all good dies, the unqualified chips that have
not been removed are left on the cutting tape and are all discarded when the
frame is recycled. In this process, the good chips are classified by entering
the wafer test results (pass/fail) in Mapping Table 2.
Ejection ProcessChip Ejection Process:
Enlarged view of force applied in three directions
After the dicing process, the chip is split
into individual modules and gently attached to the dicing tape. At this point,
it is not easy to pick up the chips one by one that are placed horizontally on
the cutting tape, as it is difficult to pick up the chips easily even with a
vacuum, and if they are forcibly pulled, they can cause physical damage to the
chips.
To do this, the "Ejection
process" can be used, in which a physical force is applied to the target
chip by an ejector that causes it to form a slight step with the other chips,
making it easy to pick up the chip. After ejecting the bottom of the chip, the
chip can be pulled out from above using a vacuum picker with a plunger. At the
same time, use a vacuum picker to pull up the bottom of the dicing tape to keep
the wafer flat. 3Ejector: A ejector used to jack up a chip from under the
cutting tape.
<!--[if !supportLists]-->1.<!--[endif]-->Die bonding
process using epoxy resin for bonding When performing die bonding, alloys made
of gold or silver (or nickel) can be used, especially for large hermetic
packages. Joining can also be done by using solder or a paste containing metal
(Power Tr), or by using a polymer (Polyimide) for die bonding. Among polymer
materials, epoxy resins containing silver paste or liquid are relatively easy
to use and are used frequently.
When using epoxy for die bonding, a very
small amount of epoxy can be precisely placed on the substrate. After the chip
is placed on the substrate, the epoxy resin is hardened at a temperature of
150°C to 250°C by reflow or curing, which bonds the chip to the substrate. In
this case, if the thickness of the epoxy resin used is not constant, warpage
due to differences in the coefficient of expansion may occur, which may lead to
bending or deformation. So, while it is advantageous to use a small amount of
epoxy resin, there are different forms of warpage as long as epoxy resin is
used.
Because of this, an advanced bonding method
using die attach film (DAF) has become the preferred method in recent years.
Although DAF has the disadvantage of being expensive and difficult to handle,
it is easy to grasp the amount of usage and simplifies the process, so the
usage rate is gradually increasing.
<!--[if !supportLists]-->1.<!--[endif]-->Die bonding
process using wafer bonded film (DAF) / Figure 6. Die bonding process using
wafer bonded film (DAF).
DAF is a thin film that adheres to the
bottom of a grain. ▶ Please refer to: Dicing, splitting a wafer into multiple semiconductor chips. Compared to
polymer materials, DAF enables the thickness to be adjusted to a very small and
constant degree. DAF is not only used for chip-to-substrate bonding, but also
widely used for chip-to-chip bonding, resulting in multi-die packaging (MCP).
In other words, the DAF that is tightly bonded to the chip waits for the dicing
process to complete and then plays its part in the die bonding process.
From the structure of the dicing chip, the
DAF located at the bottom of the chip supports the chip, while the cutting tape
pulls the DAF located below it with a weak adhesive force. In this structure,
die bonding is performed by placing the die on the substrate immediately after
removing the chip and DAF from the dicing tape, and epoxy resin cannot be used.
Since the dispensing process can be skipped during this process, the pros and
cons of epoxy resins are ignored and replaced by the pros and cons of DAF.
When DAF is used, some air penetrates the
film, causing problems such as film deformation. As a result, the precision
requirements for the equipment that processes DAFs are particularly high.
Still, DAF is the preferred method due to its ability to simplify the process
and improve thickness uniformity, resulting in lower defect rates and higher
productivity.
Depending on the type of substrate (lead
frame or printed circuit board) used to place the chip, the direction in which
the die bonding is performed varies greatly. PCB-based substrates have long
been widely used because they can be used in small-format mass production
packages. Correspondingly, as bonding technologies become more diverse, the
temperature profile used to dry adhesives is constantly changing. Some of the
representative bonding methods include heat bonding and ultrasonic bonding.
With the continuous improvement of integration technology, the packaging
process continues to develop in the direction of ultra-thin, and the packaging
technology has also become diversified.
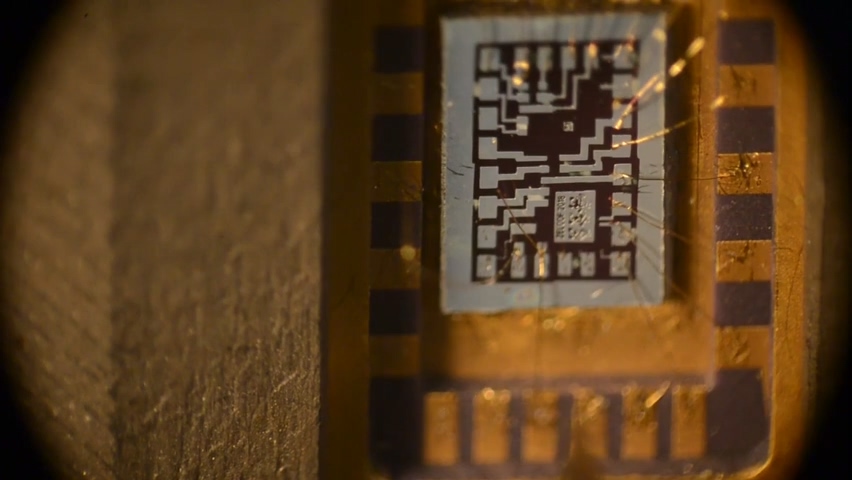
Die bonding technology has different
development directions under different substrate types. For PCB-based
substrates, they have a long history and a wide range of applications for
small-format mass production packaging. With the advancement of technology, the
diversified development of bonding technology has also led to the continuous
change of the temperature profile of the drying adhesive. Bonding methods such
as heat bonding and ultrasonic bonding are representative of this diverse
development.
In the whole process of packaging process
development, with the continuous improvement of integration technology,
packaging is developing in the direction of ultra-thin, which makes packaging
technology more diversified. Die bonding processes, whether traditional methods
using materials such as epoxy resins or emerging methods using wafer bonding
films, are constantly evolving and optimizing to accommodate the trend of
shrinking semiconductor chips and increasing packaging requirements. From the
steps of die bonding to the comparison to flip chip bonding, from the use of
different materials to the differences in operation under different substrate
types, each step demonstrates the importance of this process in the back-end
process of semiconductor manufacturing and the need for its continuous
development.
 苏公网安备32058302004438
苏公网安备32058302004438