意见:1 创始人: Site Editor Publish Time: 2025-03-06 Origin: 网站








键合工艺技术是半导体封装环节中的重要技术方法, 而键合系统相关的失效也直接影响着电子元器件的互连可靠性。虽然同为键合区域的失效,
但失效机理却千差万别。针对性地讨论了 Au-Al、 Cu-Al 和 Al-Al这 3 个键合系统中常见的基于材料特性和工艺过程的失效模式。结合相关实际案例,
采用扫描电子显微镜(SEM)、十、射线能谱分析仪 (EDX)、 离子研磨 (CP) 等物理和化学分析手段, 研究并分析了键合工艺开裂、
双金属间键合退化、 接触腐蚀和功率器件的键合丝退化等模式的失效机理, 得到各种失效模式对应的失效原因为键合工艺参数不适配、 金属间化合物 (IMC) 过度生长、 原电池效应和金属层疲劳剪切力与形变等。通过列举的检测方法能准确识别器件的失效模式, 并对症提出相应的改善策略,
为提高键合系统的可靠性提供指导。同时, 可以通过功率循环试验观测和识别功率器件的键合退化。
在与微电子器件的封装相关和在使用过程中产生的失效中, 键合系统的相关失效占据了相当的比重。键合系统的失效并不仅仅只是因为该相关工艺的方式方法的问题, 而是与材料、 封装缺陷、 工艺参数、 污染、 应用场景、 外部机械应力和电应力等因素的影响都息息相关。因此, 正确鉴别失效模式并采用合适的方法进行分析以确认失效原因及机理对相关研究工作起到了重要的作用。通过准确的辨认失效模式, 针对其根本原因采取正确的方法来进行改善, 为提升产品可靠性节约了时间成本。
键合工艺基础及键合系统
1.1 键合工艺
利用金属线将芯片表面的电极焊盘和基板或引线架相连接的过程称为键合。以典型的金丝键合工艺举例, 其工艺步骤主要包括:
a) 利用打火杆放电将尾丝熔球;
b) 劈刀下行使熔球压接在键合区, 施加超声功率;
c) 形成球形键合点 (通常称为第一键合点)后, 上行劈刀连带键合丝以一定的弧度行至引线架对应区域;
d) 下行压接在引线架上对应的键合区域, 施加超声功率, 动作时间结束后停止,
切断金线形成楔形键合点 (通常称为第二键合点), 上行劈刀保留露出的尾丝。不断重复以上步骤完成芯片封装中的打线键合工艺流程。
铜丝的键合工艺步骤和金丝的键合工艺步骤基本一致, 需要注意的是在铜工艺中需要注入氮氢混合气体来降低氧化的风险。铝丝一般采用超声键合法在常温条件下进行,
无需额外加热, 在劈刀上施加超声功率, 负荷的同时破环结合面表面的氧化层, 使金属紧密接触。铝线使用的劈刀不同于金线和铜线, 但步骤类似。
表 1~2 分别是标准
AEC-Q100 和MIL-STD 883中对键合点的剪切力和键合拉力的要求。例如,对于直径为 3 mil 的金球, 其剪切力一般要求大于30.8 g, 对 3 mil 的金线其拉力要大于 15 g。
1.2 各金属丝材料的特性
作为理想的键合引线材料应该具备接触电阻小、 导电性好、 化学稳定性高、 机械性能好和能维持稳定形状等特点。金丝的化学稳定性好、
抗拉性能强, 相对来说金丝键合的工艺也比较完备和成熟, 而金丝作为键合使用的缺点在于其金属间化合物 (IMC:Intermetallic Compound) 易于过度生成降低了其机械强度。
现代消费类产品中通常会选用铜键合工艺来降低成本。一般来说铜丝的硬度大, 键合时需要更大的键合压力和超声功率, 对于相同尺寸的键合点,铜键合的剪切力和拉力也略高于金丝。但与此同时,
大应力参数的施加也会加重芯片本身的裂纹风险。对需要走大电流的器件或模块而言,铜键合拥有更高的抗疲劳特性能可通过更长时间的功率循环试验,
可以保障更长时间的产品寿命。
对于功率器件, 通过大电流的键合引线或连接最普遍的是采用铝工艺。通常, IGBT 功率模块中使用直径大于等于 300 μm 的 Al 丝作为连接, 对应的传输电流可超过 18 A。普通的金属丝在极限电流下会形成类似于熔断器的作用, 引发类似飞弧现象导致系统出现严重故障, 合理地增加键合丝直径和数量优化芯片顶部接触需求,
才能保障安全,所以不难发现键合铝线的线径通常较粗, 功率器件也会选用多根键合丝甚至铝带走大电流。此外, 功率器件也适用覆
Al 的铜丝, 目的在于结合铜丝优越的电气性能和铝丝的键合工艺, 改善组装连接 的 热 膨
胀 系 数 (CTE:Coefficient of Thermal
Expansion), 降低电阻率, 提高热导率。
1.3 键合系统
在完整的键合系统中, 除了键合引线外还需要考虑另一个重要的接触面——焊盘
(PAD)。常规的键合系统通常包括:金-金、 铝-铝、 金-铝和铜-铝等。
芯片焊盘剖面结构示意图如图 1 所示, 自上而下的结构中主要包括:
a) 钝化层
主要用来保护四周焊盘区域, 中间部分通过窗口打开用于键合;
b) 顶层金属
常用的为铝金属, 用于直接键合连接;
c) 通孔
用于连接顶层金属与下层金属;
d) 电介质
作上下两层互连金属间除通孔外的区域填充;
5) 下层金属
PAD 的结构中可调节的关键因素是顶层金属的厚度和通孔的阵列排布, 较厚的顶金能提供更好的应力缓解作用,
高密度的通孔阵列能减少电介质的开裂风险。
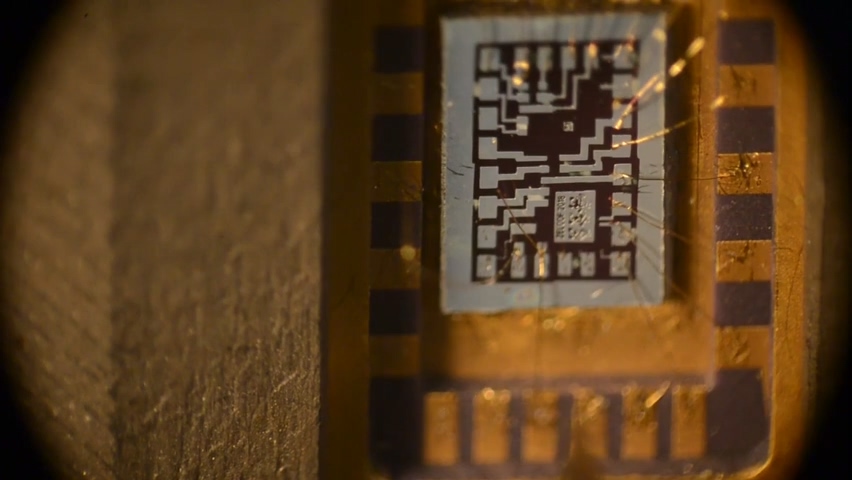
02键合系统中不同失效模式的机理研究及其检测方法
2.1 键合工艺开裂
键合裂纹又称为 “弹坑”,
最易发生在 Cu-Al键合体系中。金键合的工艺是相对早期发展起来的, 工艺较为成熟, 但随着规模的扩大、 市场竞争的不断加剧,
降低成本成了封装产业关注的焦点。铜键合由于其低成本优势和优越的物理和电学性能从中脱颖而出, 并且工艺平台和金键合的相差不大所以容易被移植, 逐步成为消费类市场键合工艺的趋势。但同时也由于键合过程
(接触、 预键合和键合) 的参数的提升, 使得该种方式与其他材料的特性参数不匹配而引起键合开裂的现象。
键合开裂的检测一般可用化学方法开封后采用光学或电子显微镜进行观察, 利用强腐蚀性的酸类(硫酸和发烟硝酸) 去除模塑化合物后暴露芯片键合区,
部分情况下尤其是键合功率过高的情况, 可以直接在 PAD 表面看到分层甚至开裂现象, 如图2 所示。在无法充分观察的情况下, 可以选择用强酸对键合区域进行去层 (去键合点及顶层
Al) 处理后, 在 PAD 区域进行观察。
在整个铜键合过程中有几个关键的影响因素,如果键合压力足够大, 会使这一阶段中铜球充分发生形变, 接下来键合过程中的超声功率就可以被均匀地施加在接触界面从而形成良好的结合。但如果在铜球没有充分形变的情况下就已经开始施加较大的超声能量,
则会被直接作用于铜-铝结合界面, 这样会对下面的电介质层造成损伤, 随即产生裂纹。
除了调整过程的工艺参数外, 也可以选择从结构上来优化铜-铝键合系统。通过增加铝层的厚度也可以明显地降低裂纹风险。PAD 上的顶层金属铝具有良好的延展性, 增加金属厚度可以有效地缓冲电介质的受力情况。或者, 通过改变通孔阵列(常用钨通孔),
提升通孔阵列密度, 增加介质层强度, 改善开裂情况。
2.2 双金属间键合退化
在键合系统中由于 2 种不同金属间的过度扩散会导致脆弱的金属间化合物大量积累,
从而使界面的结合强度下降, 接触电阻变大, 引发产品失效。
对于 Au-Al 键合由于两者化学势不同, 在高温条件下会产生多种金属间化合物,
在高于 200 ℃的形况下易生成 5 种金属间化合物, 即:Au2Al、AuAl、 AuAl2、 Au4Al 和 Au5Al2, 其中以
Au5Al2 为主。由于各种IMC的晶格常数和 CTE 不同,
再加上形成阶段导致体积分数不一致, 所以不同形成和适用环境条件作用下使得其差异较大。元器件经过高温或长期使用后就容易出现结合面变脆、 键合强度下降等情况, 严重的会使得产品出现功耗变大甚至开路等失效模式。通过化学或机械方式开封后可以通过光学显微镜观察到 “紫斑” 或 “白斑” 的现象, 即 AuAl2 或
Au2Al 呈现的颜色。对键合点做切片截面可以观察到IMC的厚度变化。
Au-Al相关的另 一 种失效模式是柯肯达尔(kirkendall)效应, 主要发生在金面, 这是因为在高温条件下金的扩散速度比铝快, 金向铝的迅速扩散产生大量 Au2Al, 并在金面产生细小的空洞和裂纹, 在后续的应用微空洞逐渐聚集连和并扩展, 导致最终脱落。柯肯达尔空洞一般很少发生于 Cu-Al界面, 很大程度上是因为铜铝的金属间化合物的生成速度相较之下慢。同样在
200 ℃的条件下 Au-Al形成100 A的合金层需要的时间不到0.3s, 而Cu-Al 则需要约 20
s 的时间。
对于 Cu-Al 键合系统而言, 在高温条件下金属 间 相 互 扩 散 形
成 金 属 间 化 合 物 , 即 :CuAl2、CuAl 和 Cu9Al4 。一般情况下, 铜铝界面的IMC会随着不断使用和时间延续而不断加厚,
这样会降低金属间的结合强度使结合系统脆性增加, 最终出现接触电阻变大甚至开路。在元器件的可靠性试验中一般通过高温存贮试验 (HTSL)
来加速IMC生长, 来评价器件的可靠性与使用寿命。
通过试验观察了不同材料的键合丝组成的键合点的IMC随时间生长的变化情况(如图 4 所示), 可以看出在 500 h 的高温试验后IMC的厚度出现明显加剧, 在1 000 h后 Au 和键合点的IMC达到了接近
3.5 μm。此外, 在铜丝中掺杂钯元素能有效抑制其IMC增长。
2.3 接触腐蚀
当不同种类的金属在电解液或类电解液的环境中产生电接触时, 由于电位差产生了电流 (电子传输), 出现类似于原电池的工作机制。低电位的金属为阴极,
高电位的金属为阳极, 阳极金属被逐渐消耗腐蚀。通常来说电势差越大, 接触腐蚀发生的概率越大, 腐蚀现象也会越严重。以
Cu-Al 键合系统举例, 在铜铝接触里铜为阴极、 铝为阳极, 阴极铝在这个过程中被慢慢消耗同时使得铜铝界面产生裂纹
接触腐蚀的失效模式多表现为键合点的接触电阻异常甚至开路, 这种失效机制一般不会直接引起漏电或短路风险。用化学开封观察会发现键合点很容易脱落,
图 5 化开后可见铜键合点脱落, 剩下键合点周围的铝金属和局部裸露下方的介质层。区别于前文提到的键合工艺裂纹现象,
接触腐蚀并不会对铝层下方的介质层造成裂纹等物理性的破环, 所以可以对键合区域去层观察下方介质层是否存在开裂形貌来加以辨别。对接触腐蚀的键合点做切面,为了更好地观察到IMC和腐蚀形貌可以先对其进行离子研磨后再在扫描电子显微镜 (SEM)
下观察, 图 6 中铜键合有明显开裂现象, 四周的铝焊盘连接处存在明显的腐蚀现象。在严重腐蚀的键合点也可用 EDX 检测出卤素。
已知金属 Au 的电极电位为+1.498
V,铜的电极电位为+0.337 V, Al 的电极电位是-1.662 V 的情况下, 为什么接触腐蚀更易发生在电位差相对较小的 Cu-Al 之间呢?这就又要提到不同IMC的形成速率, 上文中说过 Au-Al 之间的反应速度更快,这将直接导致其IMC更厚, 而在接触腐蚀的机理中厚的IMC起到了更好的缓冲作用平稳了电势差,相反, Cu-Al 之间缺乏这种有效的缓冲。另外,
由于铜相比 Au 更容易在潮湿的环境中出现氧化反应, 而生成的 Cu2+又抢夺了铝的电子发生还原反应, 最终导致 Al 被氧化, 这样的不断反应使铜界面出现裂纹而 Al 金属被腐蚀消耗。
可通过以下方法来减少出现键合点接触腐蚀概率:首先, 可以通过譬如提高键合温度来增加Cu-Al
的IMC厚度来增强键合点本身的可靠性;其次, 可以选择采用低吸水量和更少卤素含量的封装材料来降低氧化和腐蚀反应发生的可能性;再次,
可以通过采用镀钯铜线 (PCC) 更好地阻止接触腐蚀发生。
2.4 功率器件的键合丝退化
功率器件的键合丝退化往往难以单独观测, 这是因为在参数退化的阶段结构上没有伴随着明显的失效, 而且这种老化是以组合的方式来激发器件内各种材料和几何结构的退化。一旦键合丝脱离断开时,
由于大电流的加载, 分离界面会瞬间产生飞弧打火烧蚀甚至损坏器件, 也破坏了原始形貌特征。
一般会采用可靠性试验的方法来监测和检测器件退化。针对上文中所述的一些键合失效常使用到的可靠性验证是通过温度循环或温度冲击等试验模拟环境变化来实现的,
这相当于是对元器件施加了一个外界的环境应力。当然, 有些情况下也会给器件通电, 但由于试验主要是模拟环境温度变化, 所以电流和电压对其影响并不大, 其主要目的在于激发各种不同材料结合界面由于热膨胀系数的差异和循环变化带来的应力激发和变化。而对于本节所述的针对功率器件的可靠性试验还需要选择功率循环试验,
它是通过给器件一定的电流使自身产生的消耗主动加热再断电后被动降温, 从而让每个周期内器件结温变化 (ΔTj) 保持在一个恒定值
(通常来说是 100、 125 或 150 ℃)。在每一个温度波动期间, 不同材料 CTE 的差异与器件本身的几何构建之间不同方向的温度梯度产生应力从而造成材料与其连接的疲劳。正常规律下,
器件在经历一定的循环周期之后热阻开始缓慢增加, 而更长时间 (一般大于 5 000 个循环) 后电参数 VCE 开始逐步升高,通常标志着键合丝已经在发生退化, 继续试验会出现键合丝的开裂甚至脱离。键合点的退化也会引发连锁反应,
键合点在不断退化的过程中接触电阻会逐渐变大, 这将使得器件的功耗增大温度持续升高, 亦会引起焊料的退化导致散热的退化, 既影响芯片焊接的可靠性又影响了键合点。可以通过检测VCE 的变化来判断键合的状态, 譬如当这个增涨超过 5%的时候判据终点。
通过功率循环试验可以观察到铝键合的退化的示意图 (如图 7 所示), 从图 7 中可以看出键合丝发生了一定的位移并在键合点发生脱离。还有一种退化情况是键合点根部开裂 (如图 8 所示)。对于MOS管一般采用机械方法去除表面模塑, 对于 IGBT 一般采用机械开封去除外壳, 再用化学方法去除有机硅凝胶或环氧灌封树脂, 随即对键合点进行观察。
2.5 小结
本节重点讨论了有关键合工艺开裂、 双金属间键合退化、 接触腐蚀和功率器件的键合丝退化这几种典型的失效模式及其机理研究, 表 3 总结了上述失效模式通常存在的键合系统、 原因和改善方法,由于不同种类的键合系统存在通用与各自特性的不同失效模式, 此处就不以键合材料为分类进行讨论。
当然, 键合系统的失效模式亦远不止上述提到的几类, 还有譬如机械应力开裂, 典型如 “爆米花效应” 中受潮后的器件由于经历显著的热过程导致的键合丝颈部开裂;腐蚀污染导致的外键合点腐蚀开路;芯片表面存在高含量卤素导致键合点区域枝晶迁移漏电;键合丝熔融等通用的机理模式,
此处不展开讨论。
通过相应的检测分析方法可以对失效或严重退化的产品进行分析, 这通常发生在产品末期也就是失效阶段。相应地, 运用已知可能存在的失效模式我们也可以对产品进行质量控制,
对于工程批或产品工艺质量评价通常发生在初始态或可靠性试验后, 通过观察键合连接的平面和截面两种方法来作键合工艺过程管控。平面观察是通过化学方式定向去除铝焊盘后观察键合球面残留IMC的区域、 面积和介质层的裂纹异常;截面则是通过对连接系统进行切片后检查结合面的IMC界面空洞、 开裂情况或焊球底部是否有异常形变, 这些方法可以用作工艺管控来判断键合的有效面积、 鉴别键合工艺质量是否达到预期水平, 从而保障产品批量的可靠性。
综上所述,键合系统在半导体封装环节中占据着至关重要的地位。从键合工艺基础出发,不同的金属丝材料如金、铜、铝在键合工艺中有各自的特性和适用场景,且键合工艺步骤也存在一定差异。而在键合系统中,除键合引线外,焊盘也是不可忽视的部分,其结构因素如顶层金属厚度和通孔阵列排布等对整个键合系统有着重要影响。
在键合系统的失效模式方面,键合工艺开裂多发生于Cu - Al键合体系,是由于工艺参数不匹配造成,可通过化学开封和去金属层观察,调整参数和优化焊盘结构改进;双金属间键合退化在Au - Al和Cu - Al界面都存在,Au - Al界面更常见,主要因IMC生长速度快、金向铝扩散快形成柯肯达尔空洞等,可通过切片作截面检测;接触腐蚀主要出现在Cu - Al界面,源于不同金属间电势差在类电解液环境下形成原电池原理,可通过开封和切片观测,提升IMC厚度等方法改善;功率器件的键合丝退化不易观察,但可依靠功率循环试验监测参数变化来预测寿命,退化后有脱离或根部断裂现象,可通过机械和化学开封检测。此外,还有其他如机械应力开裂等多种失效模式虽未详细展开,但也表明键合系统失效模式的复杂性。
针对这些失效模式的研究和检测方法,可以准确识别失效模式并确定失效原因,进而提出改善策略。这不仅有助于提高键合系统的可靠性,保障半导体器件的质量,而且在产品质量控制方面,无论是初始态还是可靠性试验后,通过观察键合连接的平面和截面都能对键合工艺过程进行有效管控,从而保障产品批量的可靠性。
键合一直是半导体封装技术中不断更新的一项重要工艺过程, 良好的键合系统也是半导体器件高可靠性的质量保证。本文首先介绍了半导体器件键合工艺过程和背景,
讨论了常用的金、 铜和铝的不同特性及在键合工艺上的主要差别。此外, 阐述了在键合系统中另一重要组成部分——焊盘,
并可通过改善焊盘的铝层厚度来增加键合缓冲,可提升金属层下的通孔阵列密度来优化介质层的整体强度从而改善键合开裂的情况。
针对键合系统的主要失效模式对其原因进行了分析, 并提出了相应的改善措施:
a) 键合工艺开裂主要发生在铜铝界面, 可通过化学开封和去金属层进行观察,
失效的主要因素在于工艺参数的不适配, 可通过调整过程参数和焊盘结构进行改进;
b) 双金属间键合退化在金-铝和铜-铝界面都有, 但在金-铝界面更普遍, 主要通过切片作截面检测, 原因是金-铝间的IMC在相同条件下生长速度快, 金-铝还易形成柯肯达尔空洞, 主要是在高温条件下金向铝的扩散速度快, 接触面金层开裂并不断消耗铝成为IMC;
c) 接触腐蚀主要发生在 Cu-Al 界面,
原因在于不同金属接触存在电势差, 在类电解液环境中会形成类似原电池的工作原理, 通常用开封方法可观察到键合点脱落, 用切片观测键合点截面可开裂和腐蚀现象, 可通过提升IMC厚度、 提升金属抗性(钯铜) 和控制封装的卤素离子浓度并降低材料吸水率来改善;
d) 功率器件的键合丝退化, 其退化不易观察但可通过功率循环试验监测参数变化来作寿命预测,
退化后会出现脱离或根部断裂等现象, 可通过机械和化学开封后进行检测。